
Anaerobic Clean Oven (SCO Series)
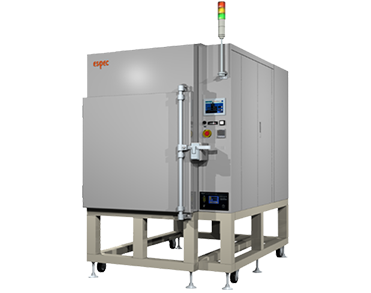
Equipment Overview
In the manufacture of semiconductor packaging, this equipment enables low oxygen heat treatment in a clean environment from 150°C to 500°C in heat treatment processes such as polyimide curing, stress relief after hybrid bonding and interlayer dielectric annealing. The highly efficient air conditioning system ensures high temperature distribution performance, as well as a significant improvement in increase and decrease characteristics, which has also enhanced processing capacity. Additionally, this equipment also enables the annealing of low temperature polysilicon TFT fabrication in the manufacture of liquid crystals, polyimide film formation for flexible display devices, and the heat treatment of semiconductor passivation film.
Features
-
- Class 4 cleanliness (equivalent to Class 10 of FED-STD-209E)*1 even during temperature fluctuations (Optional)
- Oxygen concentration of less than 60% at 10 ppm or less at temperature increase, stable, and decrease levels.*2 Performs heat processing from extremely low oxygen environments to high oxygen environments.*2 (High oxygen support is optional.)
- Slim design with a 50% smaller installation space. (Compared to conventional model)
- 50% decrease in system power capacity. (Compared to conventional model)
- High performance temperature and oxygen concentration control system enables setting of the temperature, time, and concentration for each step. (Oxygen concentration control function is optional.)
- Advanced sealing technology enables processing while controlling the consumption of gas used.
- Able to efficiently develop processes with monitoring and data logging functions for the set temperature, current temperature, set oxygen concentration, current oxygen concentration, test area pressure, and gas flow rate.All data can be output to a USB flash drive as a CSV file.
- *1: The temperature can be pulled down while maintaining a low-oxygen and clean environment.
- *2: Since the test area is not ventilated during the temperature pull-down, the air in the test area is not mixed into the general (or machine box) exhaust air, and so no flammable gas or toxic gas impact the surrounding area, even if they are generated from the specimen.
- Target processes (Example)
-
- Curing, planarization, and defoaming of insulating film in RDL (Redistribution Layer) formation and WLP (Wafer Level Packaging) processes
- Annealing and curing of interlayer dielectric film (polyimide, etc.)
- Stress relief treatment of electrical conductors
- Curing and defoaming of underfill material
- Final curing of mold resin (post-bake)
Specifications (Example)
Please scroll horizontally to look at table below.
| Supported wafer size | 2 inches (approx. 50 mm) to 12 inches (approx. 300 mm) |
|---|---|
| Supported glass size | 510 × 515 mm 600 × 600 mm Other, G1 to G4.5 glass sizes are also supported. |
| Temperature range | +80°c to +350°c (optional and supported from +50°c to +500°c) |
| Temperature distribution | ±4.5°c (at 350°c) ±7.0°c (at 500°c) (At the 35-minute mark, after reaching the control temperature) |
| Cleanliness | Class 100 (0.5 µm particles) even at temperature fluctuations |
| Internal dimensions*3 | Type 1: W540 × H445 × D500 mm Type 2: W600 × H700 × D700 mm Type 3: W750 × H800 × D850 mm Type 4: W900 × H950 × D1000 mm |
| External dimensions | Type 1: W1200 × H1140 × D1386 mm Type 2: W1400 × H1760 × D2090 mm Type 3: W1550 × H1910 × D2240 mm Type 4: W1710 × H2000 × D2510 mm |
| Main functions | Switching of nitrogen gas flow rate (large flow rate during replacement, small flow rate during stability) Atmosphere return function (quickly returns oxygen concentration to the atmosphere after the program finishes) Electromagnetic lock (oxygen concentration and temperature monitoring) Internal pressure control (controls the exhaust air volume displacement to control the pressure in the test area) |
| Options | Class 10 cleanliness support, high oxygen support, oxygen concentration control, sublimation trap, automatic sublimation drain, emergency stop switch, signal tower, automation support (automatic door), SECS-HSMS communication support, GEM communication support |
*3 Performance descriptions depend on the effective internal dimensions that are set separately.
Results
Please scroll horizontally to look at table below.
| Temperature range +80°c to +500°c |
Temperature heat-up time +80°C ⇒ +500°C/within 90 min | No load Amount of N2 applied: 250 L/min (during replacement) 110 L/min (maintaining 10 ppm) |
|---|---|---|
| Temperature pull-down time +500°C ⇒ +80°C/within 110 min Cleanliness equivalent to Class 100 in the former FED-STD-209E standard (0.5 μm) Residual oxygen concentration 10 ppm or less |
||
Recommended products for customers viewing this product
- Contact us
- Customer Support Desk
Environmental
Test Chambers
- Temperature
(& Humidity) Chambers /
Rapid-Rate Thermal Cycle Chambers- Platinous J Series Temperature
(& Humidity) Chamber - Environmental Stress Chamber
AR series - Rapid-Rate Thermal Cycle Chamber
- Bench-Top Type Temperature
(& Humidity) Chamber - Constant Climate Cabinet
- Compact Ultra Low Temperature Chamber
- Stability Test Chamber (CSH)
- Stability Test Chamber (CWH)
- Walk-In Chamber E Series / High-power Series
- Highly Accelerated Stress Test System (HAST Chamber)
- Temperature
(& Humidity) Chamber FD Series - High-Rate Thermal Cycle Chamber
- Altitude Temperature
Chamber - Altitude Temperature
(& Humidity) Chamber
MZ Series - Large Highly Accelerated Stress Test System
(HAST Chamber)
- Platinous J Series Temperature
- Thermal Shock Chambers
- Temperature Chambers
- Industrial Ovens
Temperature Chamber
Series - Industrial Ovens
Ultra-High Temperature Chamber - Industrial Ovens
Temperature Chamber
with Explosion Vent - Industrial Ovens Temperature Chamber with Rotating Specimen Rack
- Industrial Ovens Anaerobic Temerature Chamber
- Industrial Ovens High Performance Clean Oven
- Industrial Ovens Large Volume Temperature Chamber
- Desk-top Type High-Temp. Chambers
- Convection Oven
- Vacuum Oven
- One-Pass Oven
- Anaerobic Oven
(Less than 100ppm) - Large Clean Oven
- Slide Tray Oven
- Anaerobic Clean Oven
(SCO Series)
- Industrial Ovens
- Network Products
- Example Custom Orders







