
低酸素クリーンオーブン
SCOシリーズ
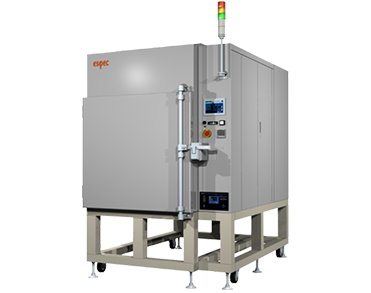
機器概要
半導体パッケージ製造における、層間絶縁膜アニールやハイブリット接合後の応力除去、ポリイミド硬化処理などの熱処理プロセスで150~500℃のクリーン且つ低酸素の熱処理を行う事が出来ます。効率のよい空調システムにより、高い温度分布性能を有し、さらに上昇降下特性も大幅に改善することで、処理能力も大幅アップしました。また、液晶製造プロセスにおける低温ポリシリコンTFT工程のアニール、フレキシブル表示デバイス用ポリイミドフィルム膜形成、半導体パッシベーション膜の熱処理も可能です。
特長
-
- 温度上昇・下降の変化時においてもクリーン度はクラス4(FED-STD-209Eのクラス10相当)※1を可能にしました。(オプション)
- 酸素濃度も温度上昇・安定・下降時において、10ppm以下~60%を実現。※2極低酸素雰囲気から高酸素雰囲気下※2での熱処理が行えます。(高酸素対応はオプション)
- スリム設計で設置スペースを50%縮小。(従来器比)
- システム電気容量は50%ダウン。(従来器比)
- 高性能な温度、酸素濃度制御システムによりステップごとに温度、時間、濃度の設定が出来ます。(酸素濃度コントロール機能はオプション)
- 高度な密封技術によって、使用ガスの消費量を抑えて処理することが出来ます。
- 設定温度・現在温度・設定酸素濃度・現在酸素濃度・槽内圧力・ガス流量のモニター、データーロギング機能により、プロセスの開発を効率的に行うことが出来ます。各データーはUSBメモリーにCSVファイルとして出力出来ます。
- ※1 低酸素・クリーン性能を維持したまま温度降下を行います。
- ※2 温度降下時は、槽内の換気を行わないので、一般(または機械室)排気に槽内気が混入する事が無く、試料から可燃ガスや有害ガスが発生しても周囲に影響が及びません。
- 対象工程(例)
-
- WLP(ウェハレベルパッケージング)、RDL(再配配線層形成)工程における
絶縁膜の硬化・平坦化・脱泡 - 層間絶縁膜(ポリイミドなど)のアニール・キュア
- 導電体の応力除去処理
- アンダーフィル材の硬化・脱泡
- モールド樹脂の最終硬化(ポストベーク)
- WLP(ウェハレベルパッケージング)、RDL(再配配線層形成)工程における
仕様(例)
左右にスクロールしてご覧ください。
| 対応ウエハーサイズ | 2インチ(約50mm)~12インチ(約300mm) |
|---|---|
| 対応ガラスサイズ | 510×515mm 600×600mm その他、G1~G4.5のガラスサイズにも対応 |
| 温度範囲 | +80℃~+350℃(オプションで+50℃~+500℃対応) |
| 温度分布 | ±4.5℃(at350℃) ±7.0℃(at500℃) (制御温度に到達後35分時点において) |
| クリーン度 | 温度変化時においてもクラス100(粒径0.5μm) |
| 内法※3 | 1型:W540×H445×D500mm 2型:W600×H700×D700mm 3型:W750×H800×D850mm 4型:W900×H950×D1000mm |
| 外法 | 1型:W1200×H1140×D1386mm 2型:W1400×H1760×D2090mm 3型:W1550×H1910×D2240mm 4型:W1710×H2000×D2510mm |
| 主な機能 | 窒素ガスの流量切替(置換の時は大流量、安定時は小流量) 大気復帰機能(プログラム終了後、速やかに酸素濃度を大気に戻します) 電磁ロック(酸素濃度と温度監視) 内圧制御(槽内圧を抑えるように排気量を制御) |
| オプション | クリーン度クラス10対応、高酸素対応、酸素濃度コントロール、 昇華物トラップ、昇華物自動ドレイン、非常停止スイッチ、シグナルタワー、 自動化対応(自動扉)、SECS-HSMS通信対応、GEM通信対応 |
※3 性能表記は、別途定める有効内寸法による
実績例
左右にスクロールしてご覧ください。
| 温度範囲 +80℃~+500℃ |
温度上昇時間 +80℃⇒+500℃/90分以内 |
無負荷 N2導入量 250L/min(置換時) 110L/min(10ppm維持) |
|---|---|---|
| 温度降下時間 +500℃⇒+80℃/110分以内 クリーン度 旧FED規格-STD-209E規格のクラス100相当(0.5μm) 残酸素濃度 10ppm以下 |
||
この製品をご覧になっているお客さまへのおすすめ製品はこちら
- 製品に関するお問い合わせ
- カスタマーサポートデスク








