TDDB(酸化膜経時破壊)評価システム
![]()
機器概要
酸化膜の信頼性評価に
高密度化・高機能化が進むLSIの信頼性に大きく関わる評価として、酸化膜の信頼性評価が求められています。
このシステムは、ウェーハをはじめガラス基板やパッケージレベルでの薄膜化による絶縁酸化膜の耐性の低下や、酸化膜の特性と平坦化による故障原因の解明に大きな役割を果たします。
仕様
左右にスクロールしてご覧ください。
| 電圧/電流印加範囲 | -50V ~+50V /-100mA ~+100mA |
|---|---|
| 分解能 | 1mVステップ/ 1pAステップ |
| 電圧/電流測定範囲 | -50V ~+50V /-100mA ~+100mA |
| SMU数 | 36SMU単位(最大324SMU) |
特長
- 測定数にあわせたシステム構成
- TDDB評価システムは、電圧電流の出力やモニタが可能なSMモジュールをチャンネル毎に装備しています。
SMモジュールは4SMUで1ボードの構成となっており、最大9ボードが収納できるユニットが基本構成(36 SMU)になっています。ウェーハレベルで最大9セット(324SMU)まで増設が行えます。
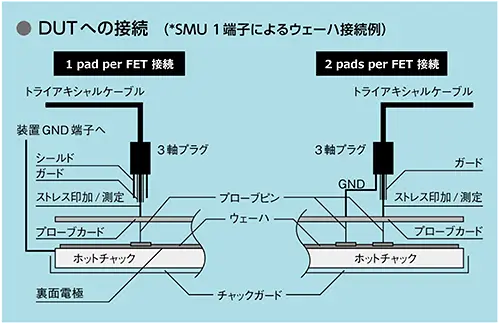
- DUTへの接続
- 高精度な電流・電圧印加測定を実現
- 電流は9レンジ、最大電流±100mA・最小電流±1pAの測定分解能。電圧では2レンジ、最大電圧±50V・最小電圧1mVの分解能を備えることで、広範囲にしかも高精度で印加/測定が行えます。
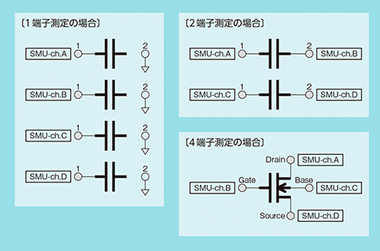
- 測定端子接続図〈TDDB〉
- 解析用アプリケーションソフトウェア(e-graph)を用意
- 試験の進行状況や測定値の変化を自動更新でリアルタイムに確認できます。測定後には測定結果からワイブルプロットの作成や寿命測定が行えます。Excelなどの表計算ソフトウェアなどのデータ変換も行えます。
- 幅広い評価項目にも対応
- ウェーハレベルやガラス基板レベルのTDDB評価が行えます。
例えば、ウェーハ表面上のコンタクトパッド(Gate)部と裏面(GND)間や、ウェーハ表面上部の2つのコンタクトパッド間(例:Gate-GND)間の濡れ電流の測定がSMU 1端子で測定可能です。
また、トランジスタを構成している4部位(Drain・Gate・Base・Source)へ4つのSMU端子を接続する事で、QDB・TZDB評価が可能となります。
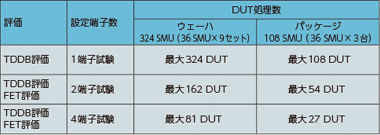
- DUT処理数
※FET単体トランジスタ特性評価を行う場合は、
追加ソフトウェア(オプション)が必要です。
- ソフトでピンアサイン変更
- キャビネット(36SMU×3セット)単位で、端子の設定変更が行えます。
また、同端子数のパッドレイアウト変更は、マルチSMU毎に、アプリケーション上で行えますので、同じプローブカードで、ピンアサイン変更が可能です。
この製品をご覧になっているお客さまへのおすすめ製品はこちら
- デジタルカタログ
- PDFカタログ(2.9MB)
- 製品に関するお問い合わせ
- カスタマーサポートデスク







