過渡熱抵抗測定機能付
パワーサイクル試験装置
![]()
機器概要
近年、パワーデバイス(MOSFET・Si-IGBT・Diode)はグリーンエネルギーや電気自動車(EV)向けなど、様々な分野で欠かせない存在となっています。特に、SiC-MOSFET(シリコンカーバイド)などの先端パワーデバイスは、高効率で低損失の電力変換を可能にし、エネルギー消費の削減と性能向上、パワーデバイス自身や受動部品の小型化に寄与しています。一方、小型化は単位面積・体積当たりの放熱量が増加するため熱管理が難しく、これらのデバイスには熱の蓄積による放熱性の課題を抱えており、設計の早期段階から適切な熱対策に加えて信頼性評価が不可欠となります。
放熱特性を評価することで、デバイスの熱設計上の課題を把握でき、デバイスの長期信頼性に向けた改善につなげることができます。
エスペックでは、これらの信頼性評価において、パワーサイクル試験装置が重要な役割を担っており、パワーデバイスの信頼性向上をサポートします。
パワーサイクル試験とは、パワーデバイスに大電流を流し、デバイス温度(Tvj)を目標温度まで発熱させます。目標温度に到達後、大電流を遮断し、チラー水や空気で下限温度まで冷却します。この温度ストレスの繰り返しにより、デバイスに熱応力を与え、ワイヤボンディングとチップ間、チップから冷却プレートまでの経路におけるパッケージ構造全体の耐久性の経時劣化を評価します。
特長
-
- 冷却方式は、水冷と空冷方式から選択
- デバイス形状・発熱に合わせた冷却治具を提案
- 独自の定電流ユニットは、ストレス電流印加時のオーバーシュートを防ぎ、遮断時のサージ電圧を抑制
- 温度特性測定α・β値を算出
- 試験種別は、時間固定パワーサイクル試験、温度目標パワーサイクル試験(Tvj、Tc)
- 印加モードは、定電流制御と定電力制御
- 評価対象デバイス(例)
-
- SiC-MOSFET、IGBT、ダイオード
- ディスクリートパッケージ、モジュールタイプ
試験モード
| 特性測定 | 温度特性測定 |
|---|---|
| 試験種別 ※各試験において 定電流/定電力の選択が可能 |
時間固定パワーサイクル試験 |
| 温度目標パワーサイクル試験(Tvj、Tc) | |
| 解析機能 | 過渡熱抵抗測定・構造関数 |
- 解析機能の構造関数について
<構造関数>
各構成部材の熱特性を可視化し、どこが劣化しているか解析できるグラフ -
-
- <エスペックの特徴>
- エスペックのパワーサイクル試験装置と、エスペック独自の低ノイズハードウェア設計、新たに採用したノイズ除去アルゴリズムを用いて、熱設計の課題解決を従来技術と比較して容易かつ明確にします。
-
-
- 従来技術
- 測定した熱抵抗のデータに対して測定ノイズがのる。そのため、構造関数にした際に界面熱抵抗が曖昧になり各部材の傾向が把握しづらい。
-
線が曖昧
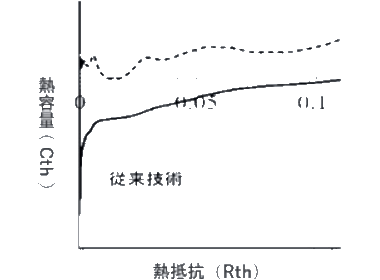
-
- 新技術
- ノイズ低減効果が高く、界面熱抵抗の明確な評価が可能構造関数にした際に明確なグラフ化ができ各部材の傾向を把握しやすい。
-
線の山がはっきりしている

-
試験方法(規格)
左右にスクロールしてご覧ください。
| 試験項目 | 試験方法(規格) | 破壊モード |
|---|---|---|
| パワーサイクル試験 | AQG324:QL-01 AQG324:QL-02 JEDEC:JESD22-A-105 AEC-Q101 |
放熱経路における破断 ワイヤ接合部の断線 |
この製品をご覧になっているお客さまへのおすすめ製品はこちら
- 製品に関するお問い合わせ
- カスタマーサポートデスク






