ニュースNEWS
AI半導体市場向け新サービス
熱変形・熱画像データを用いた基板反りCAE解析結果の
妥当性確認サービスを開始
~実測とCAE解析の融合により、半導体や電子実装基板の熱反り解析精度が大幅に向上~
2025年12月18日
エスペック株式会社(本社:大阪市北区、代表取締役 執行役員社長:荒田知)は2025年12月より、「熱変形・熱画像データを用いた基板反りCAE解析結果の妥当性確認サービス」を開始します。本サービスにより、半導体パッケージや電子実装基板をはじめとする電子部品や電子機器の、信頼性向上や評価期間短縮に寄与します。
近年、開発・設計段階において、CAE(Computer Aided Engineering)技術を活用した信頼性解析が進んでいます。またAIやEV、データセンターに用いる半導体パッケージや電子実装基板は微細配線接続されているため、周囲環境(低温~高温)の変化、機器のONOFFによる熱的ストレスが加わる際の故障リスクが従来よりも高まっています。そこでサンプルの熱膨張・収縮による反りの挙動をデジタル上でシミュレーションし、設計妥当性を検証することで評価期間を短縮する手法として、CAEによる信頼性解析が有効となっています。
一方、CAE解析の品質担保を目的に、解析結果の検証や妥当性確認に関するガイドラインが発行されています。CAE解析に発生する誤差要因として、材料データの持つ誤差や解析条件の設定などが挙げられますが、これらの誤差を完全になくすことは不可能であるため、解析結果の妥当性確認が重要となります。
この課題解決に向けて、当社はCAEソリューションのリーディングカンパニーであるサイバネットシステム株式会社(本社:東京都千代田区、代表取締役 社長執行役員:白石 善治)と連携のもと、当社開発の計測システムによる熱変形・熱画像データ(変位・ひずみ、試料表面の温度分布)を用いて、CAE解析条件を検証することで、基板反り解析精度を大幅に向上させる、基板反りCAE解析結果の妥当性確認サービスを開始しました。実測とCAE解析の融合により、半導体パッケージや電子実装基板の実装信頼性評価や、熱設計・熱対策を強力にサポートします。
今後も当社は、製品・サービスの拡充に取り組み、次世代半導体や次世代モビリティなど先端技術分野の「熱」に関する技術課題解決に貢献することで、先端技術の実用化を支えてまいります。
■ 基板反りCAE解析結果の妥当性確認サービスの用途例
- 2D、3D半導体パッケージ用サブストレートやインターポーザーの熱反り変形解析
- 半導体や電子実装基板のはんだ接合部の亀裂進展解析
- 基板用エポキシ材、アンダーフィル材、ソルダーレジスト材などの樹脂系材料の挙動解析
■基板反りCAE解析結果の妥当性確認事例
左右にスクロールしてご覧ください。
| 温度条件 | 熱変形計測 実測値 |
CAE解析結果 | ||||
| 補正前 解析結果 |
STEP1 表面絶縁膜 条件追加 |
STEP2 表面温度分布 実測値追加 |
STEP3 粘弾性 条件追加 |
|||
| -40℃ | 反り 変形図 |
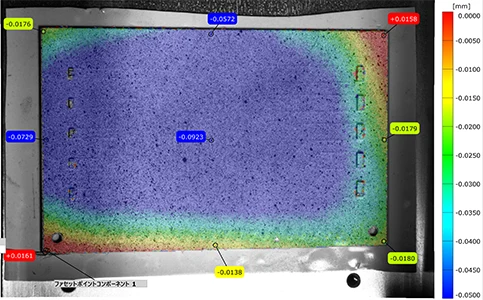 |
 |
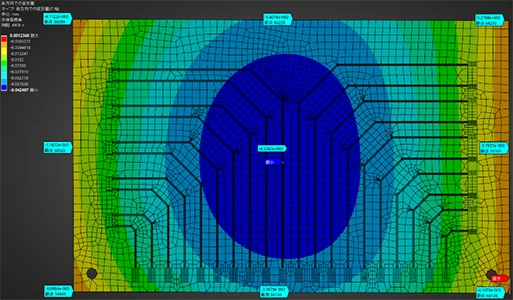 |
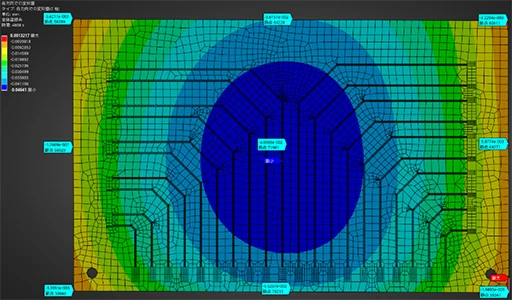 |
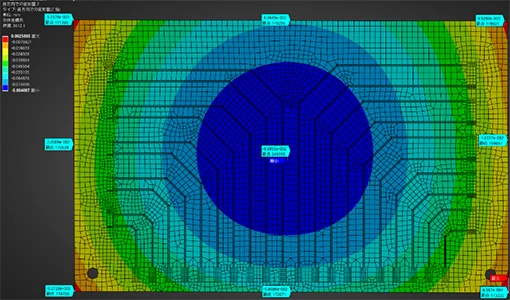 |
| 反り量 | -92.0μm | +4.4μm | -32.3μm | -46.1μm | -84.0μm | |
| 一致率 | - | -5% | 35% | 50% | 91% | |
| +125℃ | 反り 変形図 |
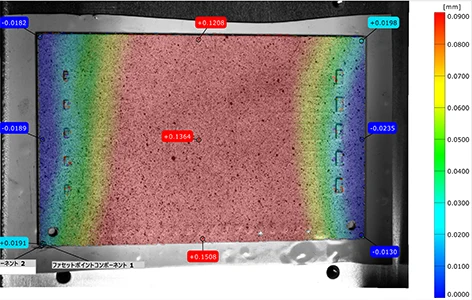 |
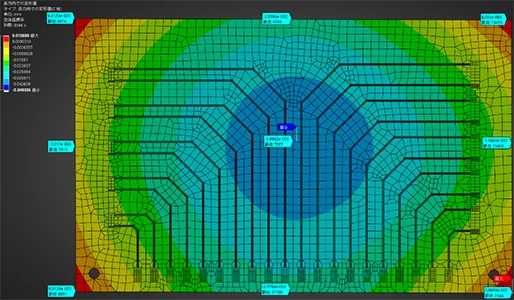 |
 |
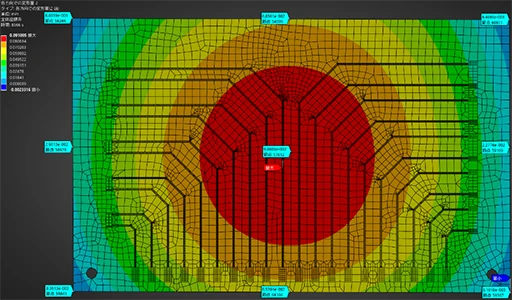 |
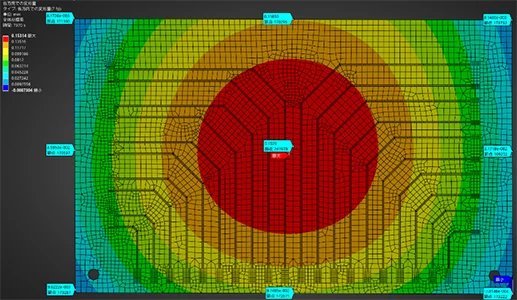 |
| 反り量 | +136.0μm | -39.9μm | +27.8μm | +90.6μm | +153.1μm | |
| 一致率 | - | -29% | 20% | 67% | 113% | |
■熱変形計測システム、熱画像解析システムの概要
3次元デジタル画像相関法(3D DIC)とエスペックの計測専用恒温槽を組み合わせ、半導体パッケージや実装基板、車載部品などの恒温環境下(-40~+260℃)の熱変形を可視化します。また、サーモグラフィで取得した熱画像解析データを取り込み、変位・ひずみ分布と温度分布を比較検証することが可能です。
-
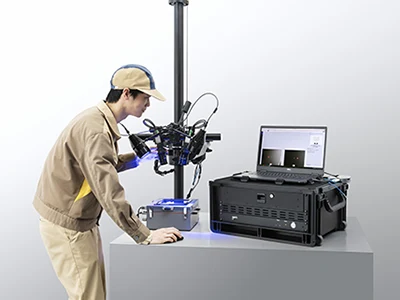
熱変形計測システム -

熱画像解析システム
<本リリースに関するお問い合わせ>
サステナビリティ推進部 IR・広報グループ
TEL:06-6358-4744 FAX:06-6358-4795
E-MAIL:ir-div@espec.jp




