ニュースNEWS
新製品・新サービス
温度環境下の半導体パッケージや実装基板の反り変形を可視化する
「熱変形計測システム」販売および計測サービス開始
2023年12月29日
エスペック株式会社(本社:大阪市北区、代表取締役 執行役員社長:荒田知)は、温度環境下における半導体パッケージや実装基板の反り変形を可視化する熱変形計測システムを開発し、2024年1月より販売ならびに計測サービスを開始します。本製品・サービスにより、半導体パッケージや実装基板をはじめとする電子部品や電子機器の信頼性確保に貢献します。
近年、携帯機器の5G(第5世代移動通信システム)化や車両の自動運転化を支える半導体パッケージや実装基板は、従来と比較しデータ転送量が多く処理速度が速いため消費電力や発熱の増大を招いており、それに伴って実装基板等の接合不良が発生します。そのため、開発・設計段階から、温度環境下における半導体パッケージや実装基板の反り変形量を正確に把握する必要があります。
この課題解決に向けて、当社は卓上型無風恒温槽※1と3次元デジタル画像相関法(3D DIC)※2を組み合わせ、温度環境下における実装基板の反り変形を可視化する熱変形計測システムを開発しました。また、スポット冷却加熱装置※3と3次元デジタル画像相関法を組み合わせることで大型な供試品にも対応し、急速な温度変化時の計測も可能としました。
今後も当社は環境創造技術を駆使した新製品、新サービスを提供し、先端技術分野の課題解決に貢献してまいります。
■熱変形計測システム 用途例
- ・実装基板の反り変形箇所の特定と熱対策
- ・熱サイクル試験時の熱変位量の確認
- ・熱設計シミュレーション(CAE)の検証
- ・樹脂モールドデバイスのひずみ分布の計測
- ・異種複合材料のひずみ計測
■熱変形計測システム 概要
- 卓上型無風恒温槽と3次元デジタル画像相関法(3D DIC)を組み合わせ、温度環境下における実装基板の反り変形を可視化するシステム。卓上型無風恒温槽の窓方向に対し、GOM社製3D DICを設置することで温度を変化させた時の反り変化量を精度良く計測することが可能。
 熱変形計測システム |
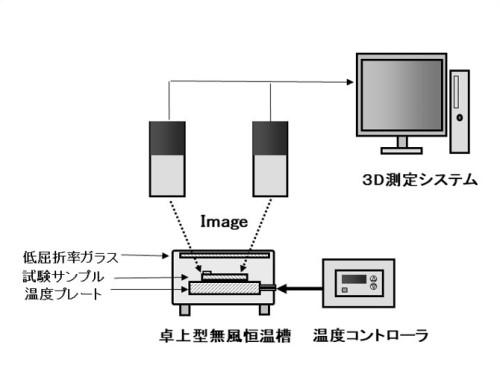 熱変形計測システム構成図 |
| ※1 卓上型無風恒温槽(MTP-100、エスペック製) 天面に大型観測窓(窓材は低屈折率の石英ガラス)を備え、温度環境下での観察が容易。AC100Vで使用可能。 温度範囲:-30℃~+130℃ 内容積:0.9L(W150×H40×D150mm) |
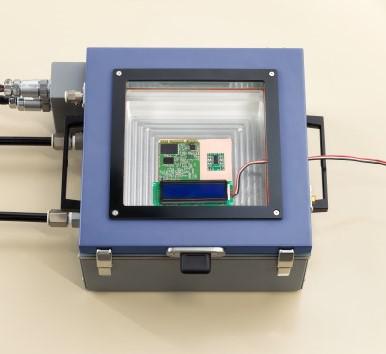 |
| ※2 3次元デジタル画像相関法(3 Dimensional Digital Image Correlation) (ARAMIS 12M+GOM Testing Controller、Carl Zeiss GOM Metrology 社製、日本総代理店:丸紅情報システムズ社) 供試品を2台のデジタルカメラで連続撮影し、供試品の変形前後の画像の変位および周囲の点の座標変化により3次元の変位・ひずみ分布を測定する方法。 GOM社は光学式3D測定の世界標準となっており3Dテスティングの専門メーカー。 |
| ※3 スポット冷却加熱装置(MTA-171、エスペック製) ホースを通じて温度調整した空気を噴射し、供試品を直接冷却・加熱し、試験を効率化するチャンバーレスシステム。 様々な計測機器や分析・解析機器等との組み合わせが可能。 吹出温度制御範囲(吹出温度設定範囲):-40℃~+180℃ |
 |
<本リリースに関するお問い合わせ>
サステナビリティ推進部 IR・広報グループ
TEL:06-6358-4744 FAX:06-6358-4795
E-MAIL:ir-div@espec.jp



